OSP是一种符合RoHS指令要求的印刷电路板(PCB)铜箔表面处理工艺。OSP是有机可焊性防腐剂的缩写。简单地说,OSP是在干净的裸铜表面上生长有机薄膜的化学过程。该膜具有抗氧化性、抗热震性和防潮性,可保护铜表面在正常环境下免受进一步生锈(氧化或硫化等);然而,在随后的高焊接温度下,这种保护膜必须很容易被焊剂去除,这样暴露的干净铜表面才能在很短的时间内立即与熔融焊料结合形成固体焊点。
OSP有三大类材料:松香、活性树脂和唑。目前,使用最广泛的是恶唑OSP。恶唑OSP已经改进了大约5代,分别命名为BTA、IA、BIA、SBA和最新的APA。
OSP的过程是:脱脂>;二次水洗>;微蚀刻>;二次水洗>;酸洗->;去离子水洗涤->;成膜空气干燥>;去离子水洗涤->;与其他表面处理工艺相比,干燥相对容易。微蚀刻的目的是形成粗糙的铜表面,以便于成膜。微蚀刻的厚度直接影响成膜速率,因此,保持微蚀刻厚度的稳定性对于形成稳定的膜厚度非常重要
- 脱脂
除油效果直接影响成膜质量。除油不良会导致油膜厚度不均匀。一方面,通过分析溶液,可以将浓度控制在工艺范围内。另一方面,还需要定期检查除油效果是否良好。如果除油效果不好,应及时更换除油液。
- 微蚀刻
微蚀刻的目的是形成粗糙的铜表面,以便于成膜。微蚀刻的厚度直接影响成膜速率,因此,保持微蚀刻厚度的稳定性对于形成稳定的膜厚度非常重要。通常将微蚀刻厚度控制在1.0至1.5um之间是合适的。
- 成膜
成膜前最好用去离子水冲洗,防止污染成膜液。还建议在成膜后使用去离子水进行清洗,pH值应控制在4.0至7.0之间,以防止污染和损坏膜层。OSP工艺的关键是控制抗氧化膜的厚度。薄膜太薄,抗热震性差。通过回流焊时,薄膜不能承受高温(190-200°C),最终影响焊接性能。在电子装配线上,焊剂不能很好地溶解薄膜,影响焊接性能。通常适合将膜厚度控制在0.2至0.5um之间。
OSP工艺的缺点:
OSP也有其缺点,如实际配方的多样性和性能的差异。也就是说,供应商的认证和选择应该做得足够好。
OSP工艺的缺点是形成的保护膜非常薄,容易划伤(或磨损),需要仔细操作和操作。同时,经过多次高温焊接工艺的OSP薄膜(指未焊接连接板上的OSP膜)可能会变色或开裂,影响可焊性和可靠性。
测试
使用OSP表面处理,如果测试点未被焊料覆盖,则会导致ICT测试期间与针床夹具的接触问题。有许多人为因素会影响ICT测试的有效性,包括OSP提供商的类型、它通过回流炉的次数、是峰值过程、氮气回流还是空气回流,以及ICT过程中使用的模拟测试类型。简单地使用更锋利的探针类型穿过OSP层只会导致PCA测试通孔或测试焊盘的损坏和刺破。因此,强烈建议不要直接检测暴露的铜焊盘,在打开钢网时,需要考虑在所有测试点添加锡。
应用指南
需要很好地掌握焊膏印刷工艺,因为印刷质量差的电路板无法使用IPA或其他方法进行清洁,这可能会损坏OSP层。
透明和非金属OSP层的厚度也很难测量,涂层覆盖率的透明度也不容易看到。因此,在这些方面很难评估供应商的质量稳定性。
OSP技术在焊盘中的Cu和焊料中的Sn之间没有IMC隔离。在无铅技术中,高Sn含量焊点中的SnCu生长迅速,影响了焊点的可靠性。
包装与储存
OSP PCB表面的有机涂层非常薄。如果长时间暴露在高温高湿环境中,PCB表面会被氧化,可焊性会变差。回流焊工艺后,PCB表面的有机涂层也会变薄,导致PCB铜箔容易氧化。因此,OSP PCB和SMT半成品板的储存方法和使用应遵循以下原则:
(a) OSP PCB来料应真空包装,并附有干燥剂和湿度显示卡。在运输和储存过程中,应在带有OSP的PCB之间使用隔离纸,以防止OSP表面受到摩擦损坏。
(b) 不要暴露在阳光直射下,保持良好的仓库储存环境,相对湿度为30-70%,温度为15-30℃,保质期不超过6个月。
(c) 在SMT现场拆包时,必须检查湿度显示卡,并在12小时内上线。切勿同时打开多个包裹。如果无法完成或设备有问题,需要很长时间才能解决,这很容易导致问题。印刷后,不要尽快留在炉内,因为焊膏中的助焊剂对OSP膜有很强的腐蚀性。保持良好的车间环境:相对湿度40-60%,温度22-27℃。在生产过程中,有必要避免用手直接接触PCB表面,以避免表面汗液污染造成的氧化。
(d) SMT单面安装完成后,第二次SMT元件安装组装必须在24小时内完成。
(e) 完成SMT后,尽快完成DIP插件(最多36小时)。
(f) OSP PCB不能烘烤,因为高温烘烤很容易导致OSP的颜色变化和劣化。


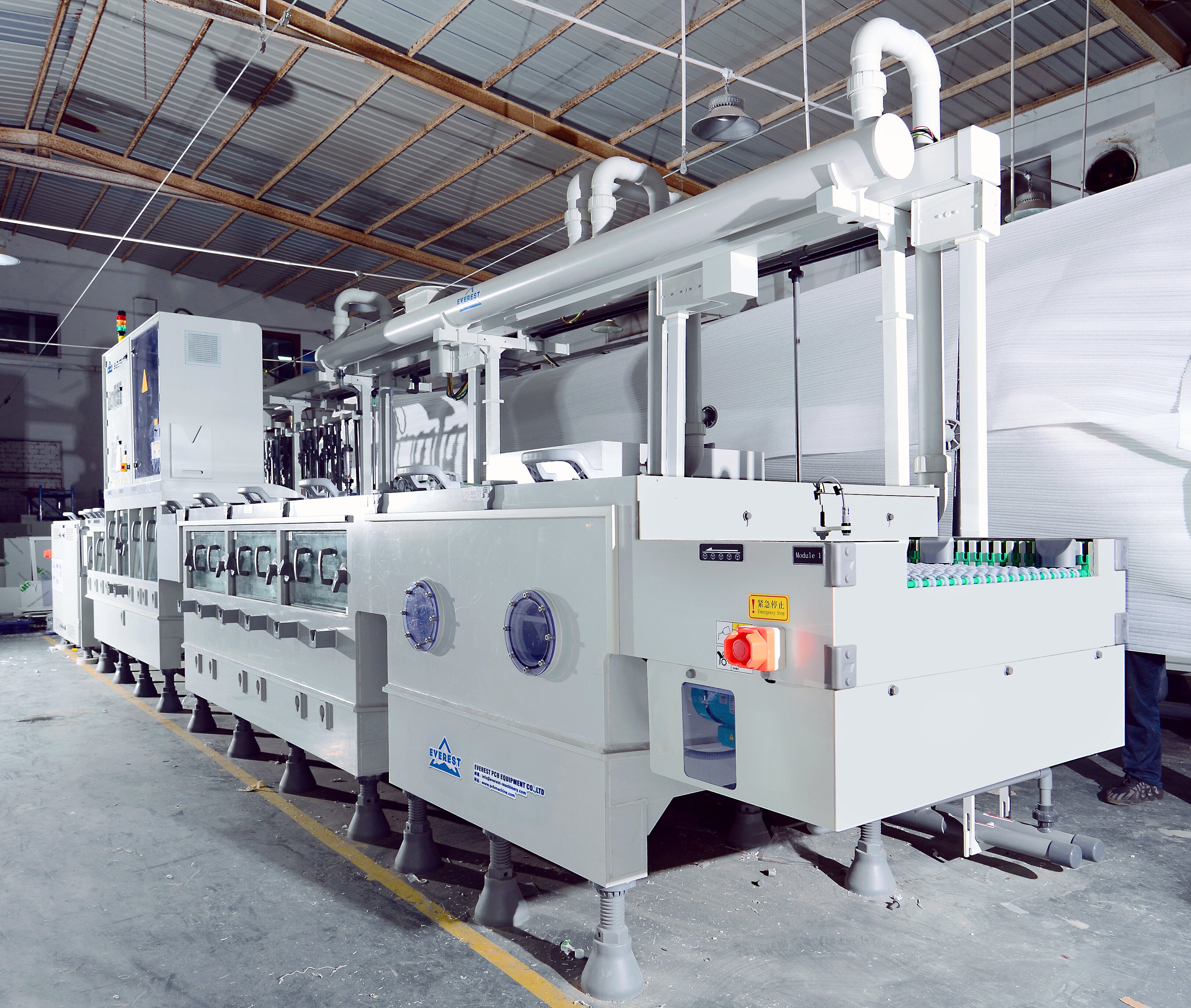

 2021年11月9日
2021年11月9日